ASML 的 EUV 光刻工具很贵。每个 EUV 工具现在靠近 1.7 亿美元,但您照样将其中的许多工具用于*的半导体工厂。未来,每个 High-NA EUV 工具的成本将跨越 3.5 亿美元。此外,这些晶圆厂还需要许多 DUV 光刻工具。每小我私人都想要一种更具成本效益的方式来图案化芯片,由于仅光刻就消耗了 3nm 工艺节点成本的约 35%。
想象一下,若是有设施打破这种趋势。
上周,天下第二泰半导体装备制造商应用质料公司宣布他们有一个潜在的解决方案。该解决方案就是 Centura Sculpta 工具,这是一种可以执行新工艺步骤“pattern shaping”的新工具。
凭证 Applied Materials 的说法,Sculpta 工具可用于将某些层的 EUV 光刻的使用削减一半之多。若是属实,这将重塑行业的成本结构。不外笔者对 Applied Materials 的说法有很大的嫌疑空间,以是让我们来谈谈这个讨论的细微差异。
在这篇文章中,我们将深入探讨新的 Centura Sculpta及其相关影响。
首先,只管有一个异常明确的用例,但半导体和金融行业的人们对这个工具有许多不屑一顾的地方。有人争辩说,这并不是什么新鲜事,它只是一种异常昂贵的电感耦合等离子体形式,用于举行反映离子蚀刻,这在大批量制造中已经存在了数十年。对此,人们也可能会争辩说,光刻手艺已经存在了 150 年,而 EUV 也不是什么新鲜事物。shaping显然是*的。
另一个主要的批判是它不成熟,而且还很遥远。那也是错误的。虽然 Sculpta 上周才在 SPIE 的光刻和高级图案聚会上正式宣布,但这个新工具已经推出很长时间了。至少从 2015 年最先,应用质料公司就一直在公布关于这种工具类型的果然研究论文。
自 2017 年以来,该公司的*个客户一直在与应用质料公司相助开发该工具。Applied Materials 甚至在去年的 SPIE Advanced Lithography & Patterning 聚会上举行了手艺演示,并提供了真实的客户测试数据。
关于该特定的演示文稿,尚有个有趣故事。在应用质料的演示竣事后,我们脱离了演示室,并与一些与会者举行了攀谈。普遍的共识是它异常酷,但行不通。为什么?介入 SPIE的公司演讲分为 3 类。1,什么即将投入生产,2,什么是多年以后,在地上种下一根木桩,3,什么基本不起作用但正在出现,由于没有其他与数据有关的器械。我们去年的假设是应用质料这个手艺是介护#2 和/或#3之间。
现在看来,那是一个错误的假设。
Applied Material 的 Centura Sculpta 并不是完全不成熟且远离生产的疯狂手艺。Sculpta 是真实的,它确实有用,它将在未来几年内发生数亿美元的收入。鉴于它被宣传为在*个用例中直接去除 EUV 双重图案化,首先让我们快速回首一下光刻多重图案化历程。
光刻多重图案化工艺
光刻是大批量半导体制造的焦点工艺。一旦突破了光刻工具的限制,您仍然可以通过转向种种多重图案化方案来继续缩放单个特征尺寸。下面是“光刻-蚀刻-光刻-蚀刻 (LELE:litho-etch-litho-etch)”的简化形貌,这是最常见的多重图案化方案之一。为了简朴起见,我们将把其他方案(如 SADP 和 LELB)放入与 LELE 相同的桶中。
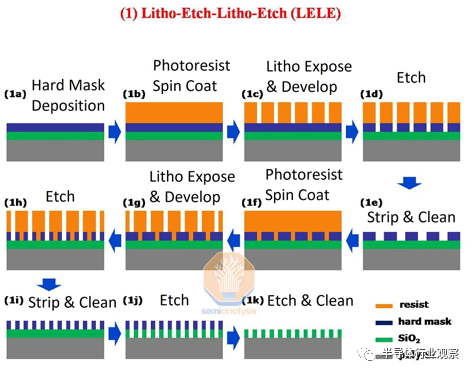
LELE 工艺流程经由两次完整的光刻周期,以实现比单个图案化步骤更慎密的特征尺寸。整个周期可以是几十个差其余工艺步骤,包罗硬掩模的沉积、底层(underlayers)、中央层(mid-layers)、SARC、CMP、清洁、剥离、旋涂、烘烤、显影、曝光、蚀刻以及其间的种种计量/检查步骤。
要害在于,从单一的光刻周期到 LELE 工艺涉及到双倍的光刻成本以及该工艺中涉及的许多其他工具。
Applied Materials 专门将 EUV 多重图案化削减作为Sculpta 的*个用例。他们声称他们可以通过单个光刻周期和 Sculpta 实现与 LELE 相同的特征保真度。
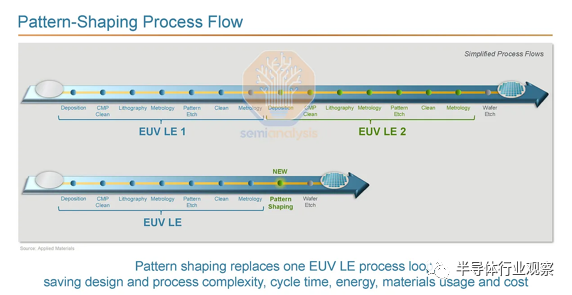
根据应用质料的说法,他们预估每个晶圆约 25 千瓦时,每个晶圆约 0.5 千克二氧化碳当量排放量以及每个 LE(光刻蚀刻)循环每个晶圆需要花费约 15 升水。在右边的框中,我们显示了成本。我们估量每月每 100,000 个晶圆启动的资源成本约为 3.5 亿美元,每个晶圆制造或每个 EUV 循环每个晶圆的运营成本约为 70 美元。通过接纳应用质料的新手艺,我们估量每月每启动 100,000 个晶圆可节约约 2.5 亿美元的资源成本,每个晶圆可节约约 50 美元的制造成本。
从上述可以看到,Applied Materials 宣称的成本、电力、水和 CO2 节约量是伟大的。台积电已将其 7 纳米和 5 纳米节点的产能提高到(约莫)每月 200,000 片晶圆。每层,这将为他们节约 5 亿美元的资源支出和跨越 1 亿美元的年度运营用度。
台积电 5nm 具有 EUV 多重图案化步骤。TSMC 3nm 包罗多个 EUV 多重图案化步骤。该手艺的目的是插入“2nm”级节点,该节点可能包罗 10 多个 EUV 多重图案化步骤,而无需 Applied Materials Sculpta pattern shaping。若是您假设 Sculpta 可以在*任何地方*使用,那么使用 Sculpta 每年可以节约*数十亿美元*。
不外我们还需要重申一下,该剖析过于简朴化,由于我们不能在所有地方使用pattern shaping 。我们将分享它的使用地址和方式,但首先让我们来谈谈什么是 Sculpta 和模式塑形。
什么是 Centura Sculpta 和
Pattern Shaping?
Centura Sculpta 的焦点是能够执行一种称为pattern shaping的新型步骤。pattern shaping是以一定角度向晶圆射出带状等离子束。与晶圆相比,角度可以控制在0到70度之间。零角与晶圆的角度成 90 度。
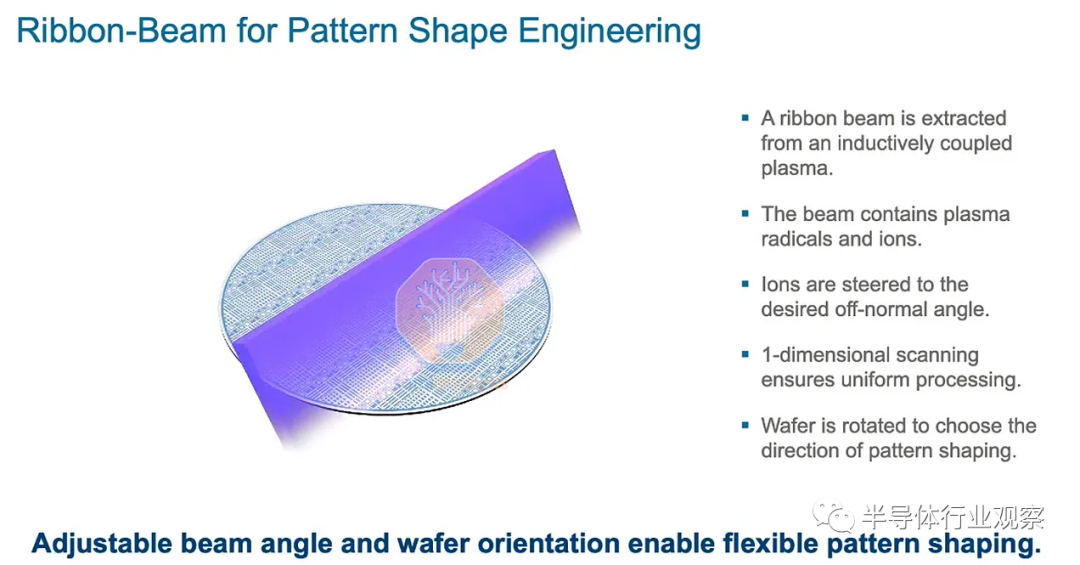
等离子束以一维方式行进,以保持晶圆上的处置平均。目的是在 1 个偏向上单向延伸特征。通过旋转晶圆并再次使光束穿过晶圆,可以在任何偏向上执行pattern shaping。

pattern shaping不能影响需要保持稳固的硅特征的要害尺寸,这一点至关主要。这意味着仅更改一个轴上的特征是至关主要的。Applied Materials 示意,对于另一个偏向上每 1 个长度单元,他们可以将单个尺寸改变 20 个长度单元。

这在偏向上是高度选择性的。晶圆厂还可以通过增添或削减带状光束轰击所破费的时间来控制图案被拉长的水平。蚀刻时间是晶圆厂可以行使的一个主要杠杆。
保持形状统一的另一个思量因素是确保针对晶圆上的种种差异结构优化光束角。
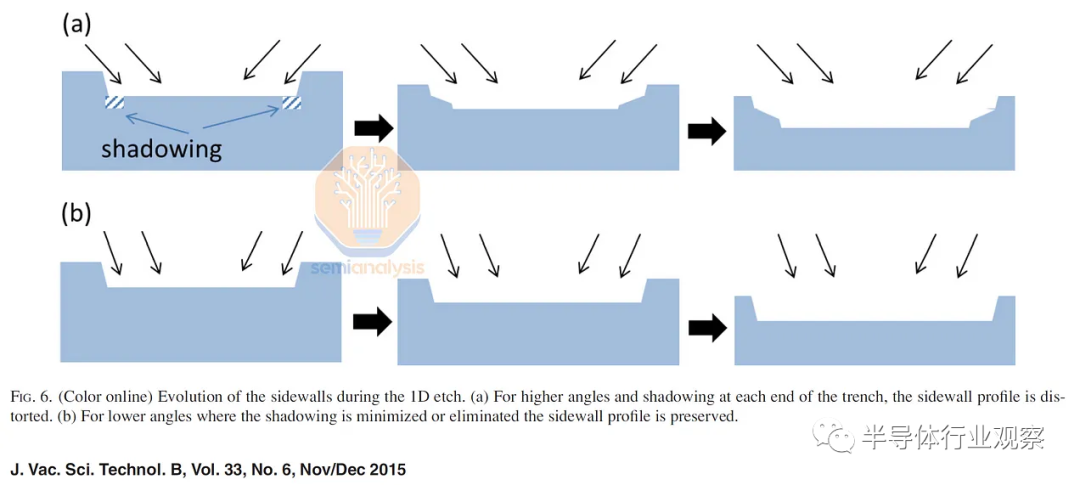
若是光束角度未准确对齐,则可能会在差异尺寸的结构上发生阴影。

若是平展化层和硬掩模具有差其余蚀刻选择性,则等离子束将导致侧壁不平均平直。
必须优化特征的侧壁轮廓,否则会泛起性能、功率或良率问题。
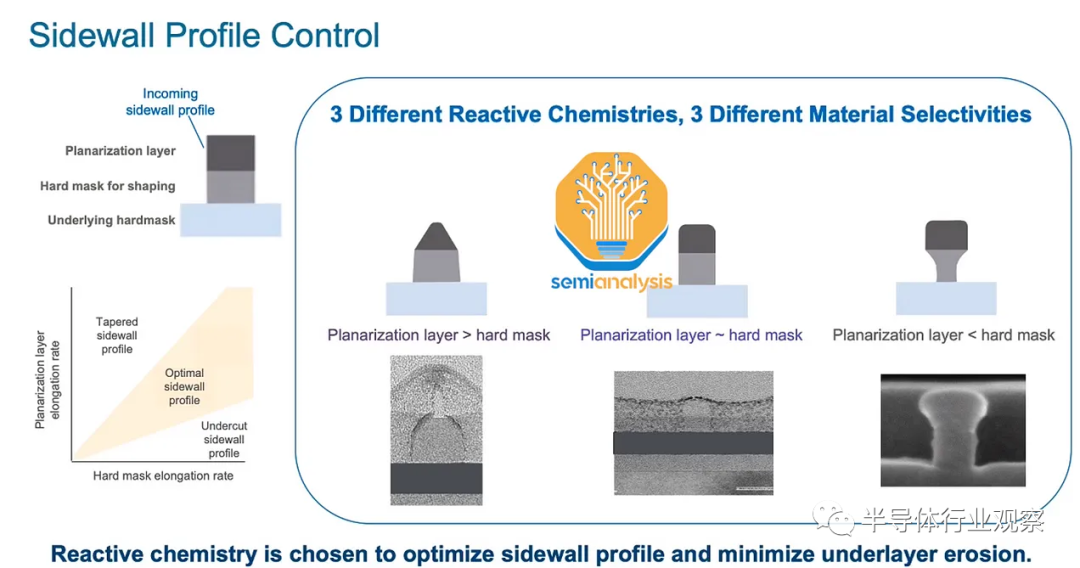
等离子束的角度对于晶圆厂举行优化以确保种种尺寸的特征具有平均一致的伸长量异常主要。使用较高的角度与较低的角度会兼顾蚀刻所需的时间、顶层的侵蚀率和底层的侵蚀率等因素,以保持要害尺寸的完整性。每个应用将有差其余光束角度和时间。Applied Materials 研究了多种差其余化学物质,因此光束可用于种种硬掩模、底层(underlayers)和中央层(underlayers)。

图案成形(pattern shaping)发生在光刻胶和抗反射涂层的显影、清洁和蚀刻之后。

一旦发生图案成形,就可以举行图案转移蚀刻。纵然您有多个掩模和图案化阶段,这也允许使用图案整形。图案整形可以与多重图案组合。
图案成型不仅仅需要朝着现有特征的偏向生长。它也可以在任何随便角度举行。对我们来说,这似乎更多地展示了 Applied 与 Sculpta 的对齐和制程控制,而不是非对称整形的现实用例。我们想不出非对称整形的用例,但若是您以为有,请分享。
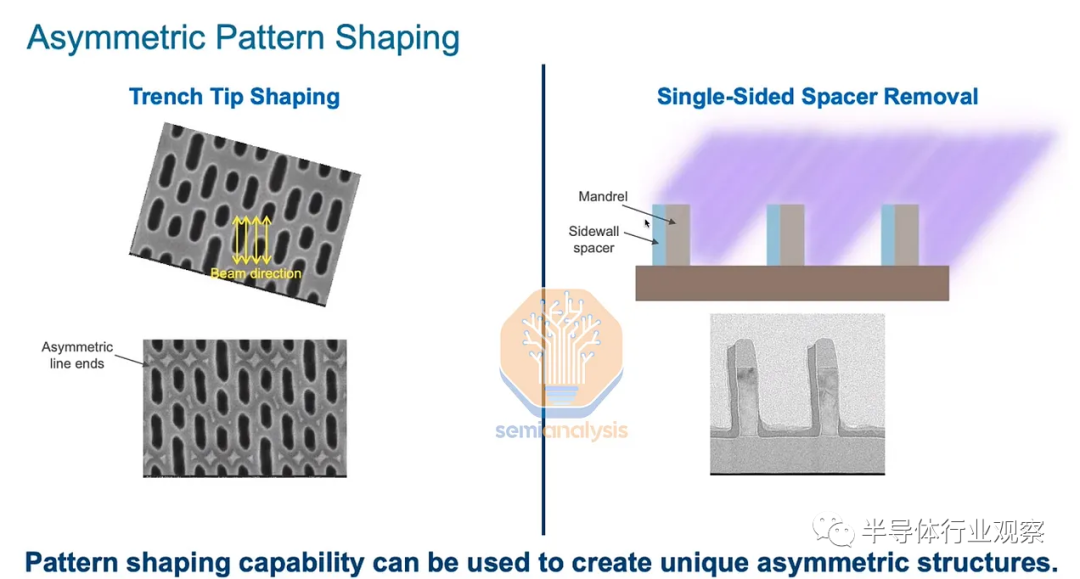
现在我们已经先容了什么是pattern shaping,是时刻先容pattern shaping的现实用例了。
用 例
Scuplta 工具有 3 个主要用例:慎密的孔(Tight hole )和槽图案(slot pattern)、更窄的尖端到尖端图案(narrower tip-to-tip patterns)以及消除随机桥接(removing stochastic bridging)。
*个应用是使用传统的光刻 (LE) 方式获得具有慎密角对角尺寸的孔和槽图案,这需要多重图案化。借助图案整形,您的优势在于只需使用一个 LE 步骤即可从一个角落到另一个角落。慎密的角对角很主要,由于它可以让您将更多功效放入统一区域。在这种使用过孔的情形下,由于有更多的过孔区域,因此可以提高性能和功率特征。
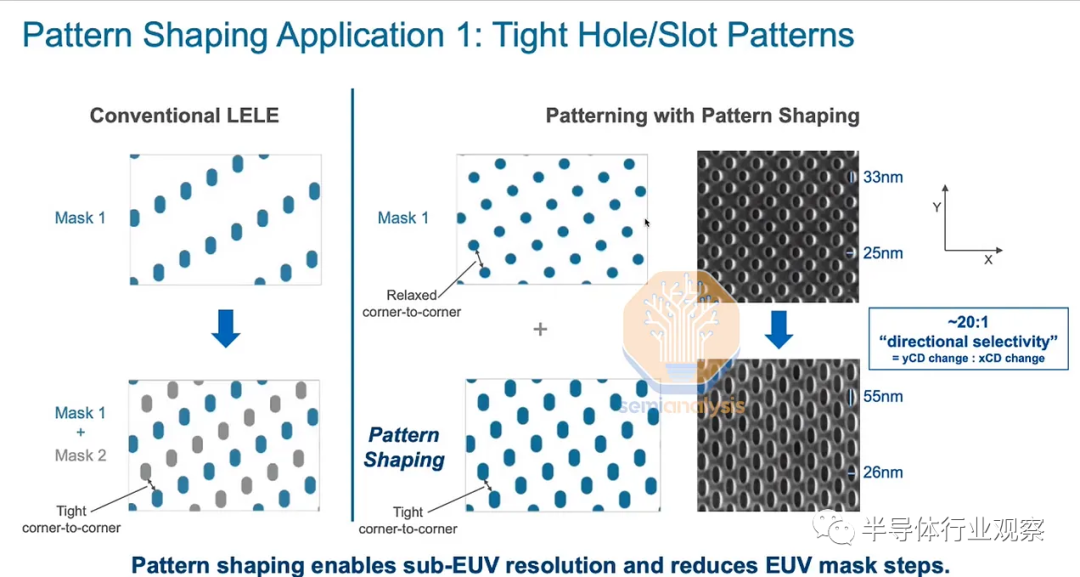
在上图中,您可以在左侧看到若何使用传统的自瞄准 LELE 手艺实现慎密的角对角。您需要 2 个差其余掩模来实现过孔的紧角对角,然则通过图案整形,您可以使用一个掩模来确立所有没有紧角到角的过孔,然后对过孔举行整形以使其具有紧角-到角落。
第二个应用是生产具有更慎密的尖端到尖端图案的沟槽。这与*个应用程序异常相似,但具有差其余功效类型。在此应用中,图形整形用于在不使用第二个掩模的情形下使两组线尽可能靠近。

左边是传统的 LELE 手艺。*个掩膜确立线条,然后第二个掩膜在两者之间确立一个拆分,以获得尽可能慎密的尖端间距。通过图案塑造,您可以使用一个掩膜确立 2 组线条,中央有一条松散的沟槽。然后 Sculpta 可以去除尽可能多的质料,使沟槽尽可能薄。

第三个应用是削减随机桥接缺陷。随机桥接缺陷位于一条线上,其中蚀刻无法去除它应该具有的所有质料。一样平常来说,这是由于光刻胶层也没有准确曝光。
这些缺陷会导致电子去不应去的地方而增添功率。若是桥最终将 2 个要害层毗邻在一起导致短路或通讯错误,它也会导致产量降低。Applied Materials 示意,通过图案整形,Sculpta 可以将这些缺陷削减 90% 以上。
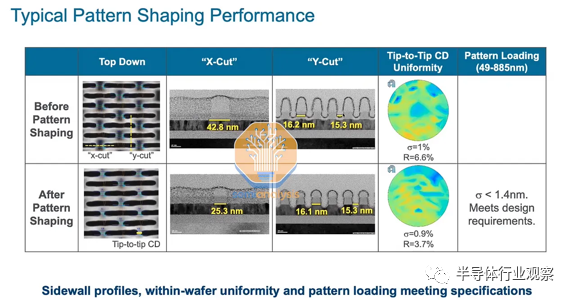
在差其余演示中,ASML 谈到了将尖端缩小到跨越 27 纳米若何最先使用 EUV 单图案化以指数方式增添随机缺陷。图案整形将有助于显著削减这些图案缺陷,由于光刻工具可以图案化更松懈的特征并将 Sculpta 形状酿成更慎密的尖端到尖端。图形整形也有助于以同样的方式削减沟槽到沟槽间的缺陷。

应该注重的是,ASML 的数据是针对简朴流程的,现实芯片中使用的庞大布线会在 30 纳米或以上使用电流抗蚀剂推动缺陷壁。
*个用例——金属互连客栈
金属堆叠是任何工艺节点中最主要的部门之一。它能够在晶圆周围路由信号。金属堆叠由十几层组成,但最主要的层是 M0 到 M4 层。就现代工艺节点的结构而言,M0、M2 和 M4 是垂直于栅极的要害金属层,M1 和 M3 平行于栅极。
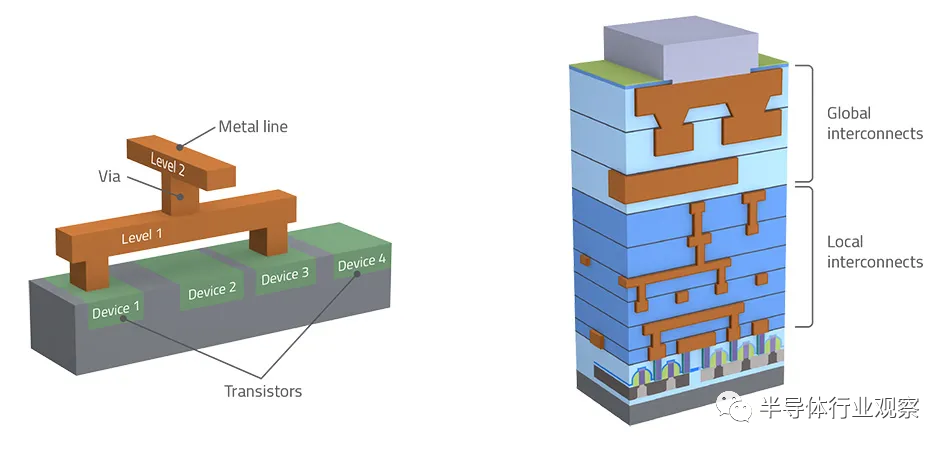
芯片的金属堆叠是一个需要举行许多庞大和难题权衡的领域。每个金属层做得越密越薄,可以完成的信号路由就越多,最终,可以将更多有用的晶体管安装到任何给定区域。然而,这是要支出伟大价值的。
制作的金属线越细,金属线的电阻就越高。记得高中时的欧姆定律。欧姆定律指出 R = (V/I),其中 R 是电阻,V 是电压,I 是电流。只管欧姆定律并不完全适用于云云细小的导线,但工艺节点集成工程师必须起劲解决因更麋集的金属层而导致电路电阻增添的问题。他们可以通过增添电压或削减电流来抵偿。简化的权衡是,与更松散的金属堆叠相比,更麋集的金属堆叠发送信号需要更多的功率。缩小金属间距并不总是一件好事。

铜是英特尔、台积电和三星 3 纳米和 4 纳米工艺节点的*金属。对于单一图案化 EUV,~32nm 约莫是当前抗蚀剂化学和笼罩能力的线间距极限。对于过孔,这个数字现实上更高。为简朴起见,假设所有特征的 EUV 单一图案化的限制为 30nm。

出于演示目的,这个示例被过分简化了。上图是芯片上的单个金属层。单个图案化 EUV 工具可以界说的每个 30nm x 30nm 单元可以是铜,也可以是绝缘体,通常是 SiO2。这不是光刻的事情原理,但它更容易注释。
若是使用 EUV 单一图案化,金属层可能看起来像上面那样。周围有许多电线将信号从芯片的一部门传输到另一部门。这些电线还毗邻到我们正在查看的芯片层下方和上方的层。在许多情形下,该层具有通孔,这些通孔将信号直接向上和向下通报到其他层,而无需路由信号。在这个例子中,由于金属只有 30 纳米宽,以是电阻有很大的折衷。
这就是多重图案化的用武之地。其目的不是填充更多的电线,而是*化铜面积并最小化 SiO2 面积。当在整个芯片中发送信号时,这将实现更低的电阻,从而实现更高的性能和功率效率。
为简朴起见,假设多重图案化的极限现在是 15 纳米而不是 30 纳米。现实上,LELE EUV 的当前极限更多在 ~21 到 ~23nm 的局限内。上限是台积电在其 N3E 工艺节点的 M0 金属层上的间距。下界就是我们后面要讨论的2nm级节点。需要注重的是,多重图案化不会直接将间距减半,由于由于堆叠叠加错误和随机性而放弃了一些余量。

若是我们的像素尺寸现在是 15nm,在这个过于简化的树模性虚构示例中使用多重图案化,布线密度将保持稳固。相反,这种保真度的增添将用于沉积相对于 SiO2按比例增添的铜。铜线宽度从 30 纳米提高到 45 纳米,尖端间距也获得改善。SiO2 绝缘体仍然存在,以防止铜信号夹杂并使芯片短路。

增添的线宽和尖端到尖端的间距会导致电阻大幅降低,并提高功率和性能。请注重,从单一图案化到 SALELE 或图案成形的转变不会同时改善针尖到针尖和线间距,此示例被强调且不切现实,无法从观点上展示潜在的利益。
在现实天下中,利益较小,但也是必须的,而且是图案整形的主要用例之一。特征的密度已经可以通过单一图案化来实现,但这些特征的形状却不能。图案整形有助于将光刻可以打印的特征带入晶圆厂所需的形状。
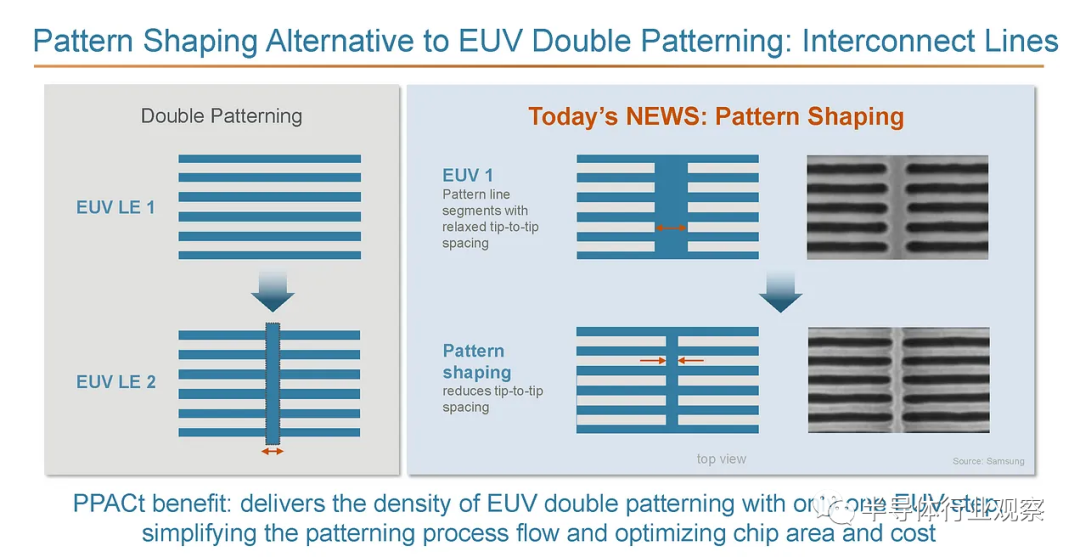
关于金属层和通孔层,也存在良率和功率折衷。过孔是毗邻差异金属层的方式。每一层都经由制造,然后*地堆叠在一起。工艺余量和叠加决议了将它们*叠加的能力。
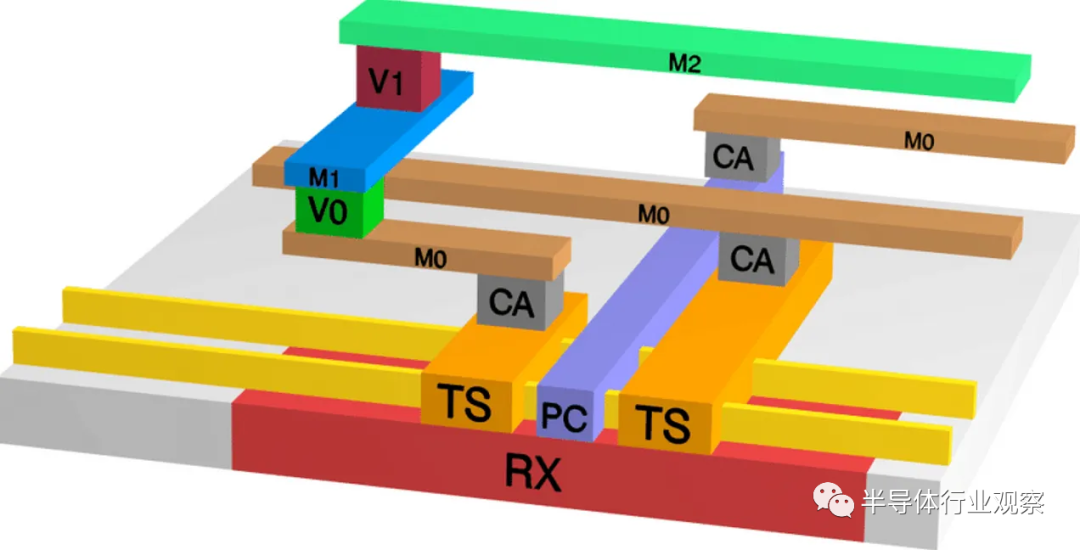
任何未对齐都可能导致一层错过它下面的一层,因此在应该有一个(打开)的地方没有确立毗邻。更糟糕的是,金属层可能会与不应该毗邻的另一层毗邻,从而发生不准确的毗邻(短路)。由于图案成形是一个选择性历程,晶圆厂可以在他们需要的偏向或数目上调高或调低定向蚀刻,以*限度地削减短路和开路,同时*限度地增添特征尺寸。
电阻问题异常主要,尤其是在图形整形最适用的较低通孔上。在 TSMC 的 N3E 节点上,跨越 90% 的通孔电阻是由 V0 到 V5 引起的。
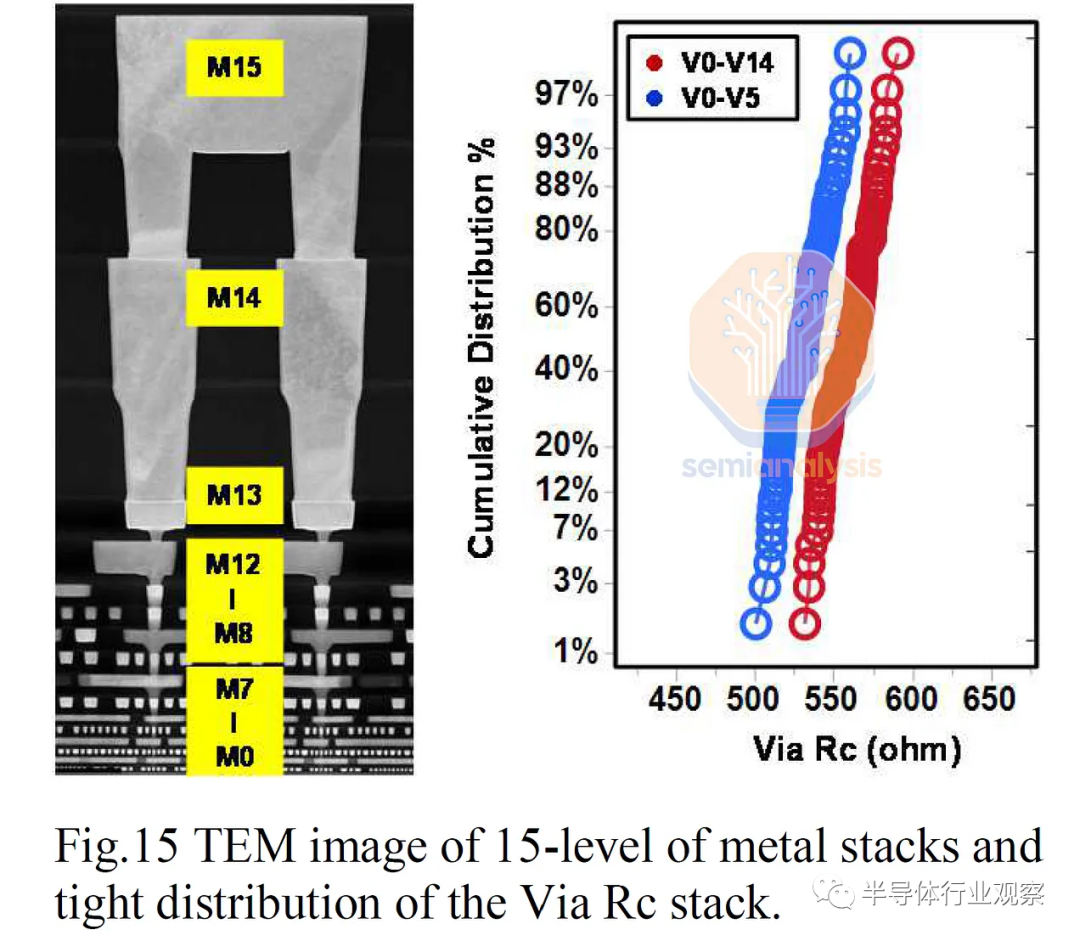
就通孔电阻而言,接下来的 9 个通孔微不足道。若是 V0 到 V5 过孔可以做得更大,但仍适合统一区域,那么电阻会降低,密度不会受到影响。

从金属堆叠的功率和性能角度来看,多重图案化带来更好保真度的权衡是很好的,但从成本角度来看,它会受到很大危险。每个金属层的工艺步骤数目险些翻了一番。
图案整形不能增添给定区域中金属层或通孔的数目,但可以增添它们的尺寸并减小尖端到尖端的间距。*个用例正在一个节点上实现,该节点将于 2024 年终 / 2025 年终用于金属客栈的量产。
EUV光刻的未来15年
同样是在SPIE光刻聚会上,ASML 的耐久首席手艺官兼 EUV 背后的生命力 Martin van den Brink做了一个主题演媾和开幕式演讲。在演讲中,Martin 谈到了 EUV 的已往 15 年和未来 15 年,以及我们的生长偏向和 ASML 的目的。
他比欧式,只管要实现High NA EUV 还需要做大量的事情,但这与最初推出 EUV 所需的事情量险些纷歧样。在他的演讲中,他展示了现有 EUV 手艺的主要重用,因此High NA 将更具进化性而不是革命性。显然,一些要害部件,例如镜头将是全新的,但需要做的工程更多,开拓性更少。
他还谈到了 1000 瓦的目的功率,现在看来比以前的功率改善更容易实现。他对他之前的功率时间表估量略有误差(我们清晰地记得)开了一些谦逊的笑话,并引起了观众的一些笑声。
到达 1000 瓦的部门缘故原由是要到达每小时 500 片晶圆,主要的是不仅在 EUV 中,而且在 DUV 中也是云云。ASML 清晰地领会人们对价钱/生产力的担忧,这种担忧尤其集中在高价光刻工具上。
在我们看来,对 DUV 的生产力关注是当之无愧的,由于它仍然是光刻的主力。
生产力是 ASML 订价计谋的要害要素。提高吞吐量是提高订价的价值理由。ASML 耐久以来一直使用这种基于“价值”的订价,支持提高订价的方式是增添每小时的晶圆数。
我们可以开顽笑说,每小时提高一个晶圆的生产率相当于一百万美元的分外订价,我们可能离得不远……。
Martin 演讲的其余部门是大量精彩的信息、事实和数据,这些内容过得太快,无法完全明晰……但值得慢速重播。
要害数据点之一是通过光刻工具处置的每个晶圆所需的功率为 100KW(10 万瓦)。这是一个惊人的数字,它不仅是激光功率,而且随着吞吐量的增添,它还能够以惊人的速率更快地加速和减速伟大的花岗岩平台块。
我们之前曾指出晶圆厂的电力需求是一个日益严重的问题。这就是三星在德克萨斯州建设自己的发电厂的缘故原由,由于它无法使用那里不能靠的电网。Martin 没有提到的另一个有趣的事实是,台积电为其晶圆厂消耗了整个台湾岛约莫 10% 的电网!
从Martin van den Brink的这个演讲,我们对应用质料的这个新工具又有了新的看法。